



憑藉其獨特的光學設計技術,新一代PL mapping測試儀, Model Imperia能夠檢測並分類導致產能下降的外延結構缺陷, 同時獲得最先進的光致發光譜作為產品監控。
通過更準確的預測MOCVD的產能和PM安排,獲得顯著的成本降低.結合這兩個後外延
測試監控功能的合併入單一高產能測試系統,可以最大限度地減少寶貴的工廠空間使用和晶圓取放片時間。
產品特點
同時測試PL譜和缺陷
軟體具備缺陷分析和分類能力
大尺寸晶圓極速測試能力,150mm晶圓可達90WPH
可選配GEM/SECS II功能,進行全自動測試
激發光波長可選 532,405,375,355nm
測試光譜範圍可選350nm-850nm和400-1000nm
PL測試功能
海量測試點數的峰值波長,峰值強度,半波寬以及其他參數
測試精度和再現性可達1nm或更小
可測試光面晶圓或圖形化晶圓,空間解析度僅125um

晶圓BOW測試功能
真正的全片測試
採用資料平滑演算法,可重建全片3D
±500 µm測試範圍
±6 µm再現性
可選配單線測試
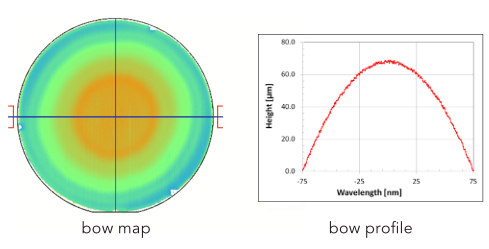
外延層厚度測試
測試精度可達2%
再現性可達1%, 1-sigma

缺陷檢測和分析
低至125um的高解析度掃描能力
亮場PL測試通道,可以檢查電激發缺陷
缺陷提取,形態分析和量化
基於Die的產能分級功能可提高產量在Die層面的預測
即時缺陷提取(RDE)軟體環境,提供KLARF檔匯出(選配)
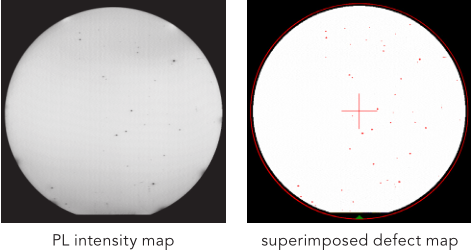

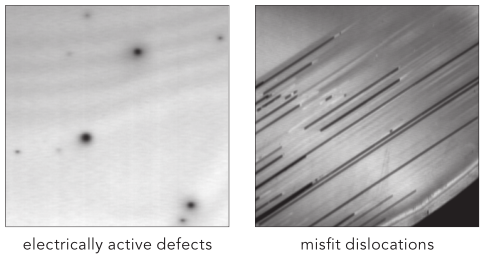
資料以R,θ方式收集、存儲,並以X,Y坐標軸方式顯示
資料和圖像可輸出至其它形式的套裝軟體
顯示比例與顏色可由使用者設定或系統預設
全光譜掃描,並對峰值波長、峰值強度、半高寬、積分強度同步收集和顯示
可以對晶片上任意一點進行單點光譜顯示和存儲
每秒可以收集180個點的全光譜或2000個點的強度圖譜
使用者自訂資料篩選功能
統計資料以數位或柱狀圖顯示
可分析合金成分
可以對系統參數和測量參數自動分段
選擇附加功能選項可完成薄膜厚度,布拉格反射體和VCSEL的特性量測






